Introductio ad carburum silicii
Carburum silicii (SiC) est materia semiconductoria composita ex carbone et silicio constans, quae inter optimas materias numeratur ad fabricanda instrumenta altae temperaturae, altae frequentiae, altae potentiae, et altae tensionis. Comparata cum materia silicii tradita (Si), hiatus zonae electricae carburi silicii triplo maior est quam silicii. Conductivitas thermalis quater vel quinquies maior est quam silicii; tensio disruptionis octies vel decies maior est quam silicii; et celeritas fluctuationis saturationis electronicae bis vel ter maior est quam silicii, quae necessitatibus industriae modernae pro alta potentia, alta tensione, et alta frequentia satisfacit. Praecipue ad productionem componentium electronicorum altae celeritatis, altae frequentiae, altae potentiae, et lucis emittentium adhibetur. Inter campos applicationis posteriores sunt retia intelligentia, vehicula novae energiae, energia venti photovoltaica, communicationes 5G, et cetera. Dioda carburi silicii et MOSFET commercialiter adhibita sunt.

Resistentia altae temperaturae. Latitudo hiatus zonae electricae carburi silicii bis vel ter maior est quam silicii, electrones non facile ad altas temperaturas transmittuntur, et temperaturas operationis altiores tolerare possunt, et conductivitas thermalis carburi silicii quater vel quintuplo maior est quam silicii, quo facilior dissipatio caloris in instrumento et temperatura operationis extrema altior fit. Resistentia altae temperaturae densitatem potentiae significanter augere potest, dum requisita in systemate refrigerationis minuit, ita ut terminales leviores et minores sint.
Pressionem altam sustinere. Vis campi electrici disruptivi carburi silicii decies maior est quam vis silicii, quod tensiones altiores tolerare potest et aptior est instrumentis altae tensionis.
Resistentia altae frequentiae. Carburum silicii duplicem ratem translationis electronicae saturatae habet quam silicii, quod efficit ut nulla sit fluxio electrica durante processu clausurae, quod efficaciter frequentiam commutationis instrumenti augere et miniaturizationem instrumenti effici potest.
Parva energiae iactura. Comparatum cum materia siliconis, carburum siliconis resistentiam in statu conductionis valde humilem et iacturam in statu conductionis humilem habet. Simul, magna latitudo intervalli zonae carburi siliconis currentem dispersionis et iacturam potentiae magnopere minuit. Praeterea, instrumentum carburi siliconis phaenomenon trahendi currentis durante processu clausurae non habet, et iactura commutationis humilis est.
Catena industriae carburi silicii
Praecipue substratum, epitaxiam, designationem instrumenti, fabricationem, obsignationem, et cetera comprehendit. Translatio carburi silicii a materia ad instrumentum potentiae semiconductoris incrementum crystalli singularis, sectionem lingotis, incrementum epitaxiale, designationem laminae, fabricationem, involucrum, et alia opera experietur. Post synthesim pulveris carburi silicii, primum lingos carburi silicii fit, deinde substratum carburi silicii per sectionem, trituram, et polituram obtinetur, et lamina epitaxialis per incrementum epitaxiale obtinetur. Lamina epitaxialis ex carburo silicii per lithographiam, corrosionem, implantationem ionicam, passivationem metallorum, et alia opera fabricatur; lamina in formam secatur, instrumentum involvitur, et deinde in testam specialem combinatur et in modulum componitur.
Superius catenae industrialis 1: substratum - incrementum crystalli est nexus processus principalis
Substratum carburi silicii circiter 47% sumptus instrumentorum carburi silicii constituit, summa impedimenta technica fabricationis, maximum valorem, est cor futurae industrializationis SiC magnae scalae.
Ex prospectu differentiarum proprietatum electrochemicarum, materiae substrati carburi silicii in substrata conductiva (regione resistentiae 15~30mΩ·cm) et substrata semi-insulata (resistivitate maiore quam 105Ω·cm) dividi possunt. Haec duo genera substrati ad fabricanda instrumenta discreta, ut instrumenta potentiae et instrumenta radiofrequentiae respective, post accretionem epitaxialem adhibentur. Inter ea, substratum carburi silicii semi-insulatum imprimis in fabricatione instrumentorum RF gallii nitridi, instrumentorum photoelectricorum, et cetera adhibetur. Accrescendo stratum epitaxiale gan in substrato SIC semi-insulato, lamina epitaxialis sic praeparatur, quae ulterius in instrumenta RF HEMT gan iso-nitridi praeparari potest. Substratum carburi silicii conductivum imprimis in fabricatione instrumentorum potentiae adhibetur. Dissimile a processu fabricationis instrumentorum potentiae siliconis traditivorum, instrumentum potentiae siliconis carburi non potest directe in substrato siliconis carburi fieri; stratum epitaxiale siliconis carburi in substrato conductivo crescere debet ut lamina epitaxialis siliconis carburi obtineatur, et stratum epitaxiale in diodo Schottky, MOSFET, IGBT, aliisque instrumentis potentiae fabricatur.
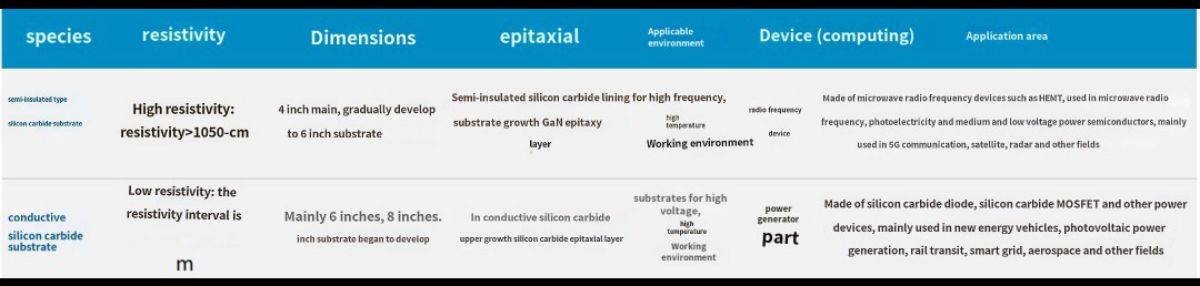
Pulvis carburi silicii ex pulvere carbonis altae puritatis et pulvere silicii altae puritatis synthesizatus est, et massae carburi silicii variarum magnitudinum sub campo temperaturae speciali cultae sunt, deinde substratum carburi silicii per multiplices processus processus productum est. Processus principalis haec comprehendit:
Synthesis materiae rudis: Pulvis silicii altae puritatis + toner secundum formulam miscetur, et reactio in camera reactionis sub condicione temperaturae altae supra 2000°C perficitur ut particulae silicii carburi cum certo genere crystalli et magnitudine particularum synthesizentur. Deinde per contundendum, cribrum, purgandum, et alia processus, ut requisitis pulveris silicii carburi altae puritatis materiae rudis satisfaciat.
Incrementum crystallorum est processus centralis fabricationis substrati carburi silicii, qui proprietates electricas substrati carburi silicii determinat. Hodie, principales methodi ad incrementum crystallorum sunt translatio vaporis physica (PVT), depositio vaporis chemici altae temperaturae (HT-CVD) et epitaxia phasis liquidae (LPE). Inter eas, methodus PVT est methodus principalis ad incrementum commerciale substrati SiC hodie, cum summa maturitate technica et latissime in arte ingeniaria adhibita.

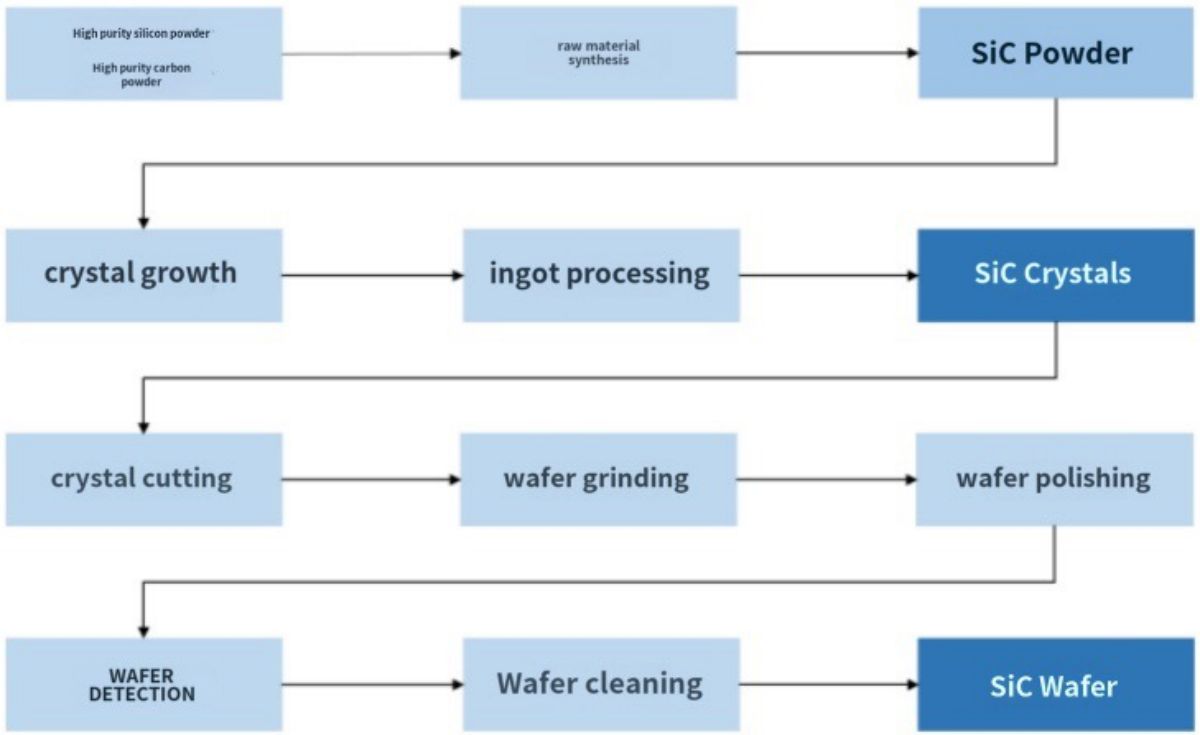
Praeparatio substrati SiC difficilis est, quod ad pretium eius altum ducit.
Difficile est moderatio campi temperaturae: incrementum virgae crystallinae Si tantum 1500℃ requirit, dum virga crystallina SiC temperatura alta supra 2000℃ crescere debet, et plus quam 250 isomeri SiC sunt. Sed structura crystallina singularis 4H-SiC principalis ad productionem instrumentorum potentiae, nisi accurata moderatio adsit, alias structuras crystallinas accipiet. Praeterea, gradiens temperaturae in crispo celeritatem translationis sublimationis SiC et dispositionem atque modum crescentiae atomorum gaseosorum in superficie crystallina determinat, quod celeritatem crescentiae crystallinae et qualitatem crystallinae afficit, ergo necesse est technologiam systematicam moderationis campi temperaturae formare. Comparata cum materiis Si, differentia in productione Si etiam in processibus altae temperaturae consistit, ut implantatio ionum altae temperaturae, oxidatio altae temperaturae, activatio altae temperaturae, et processus larvae durae ab his processibus altae temperaturae requisitus.
Incrementum crystallinum lentum: celeritas incrementi virgae crystallinae Si ad 30 ~ 150 mm/h pervenire potest, et productio virgae crystallinae silicii 1-3m tantum circiter unum diem requirit; virga crystallina SiC cum methodo PVT exempli gratia, celeritas incrementi est circiter 0.2-0.4 mm/h, 7 dies ad minus quam 3-6 cm crescendum, celeritas incrementi est minus quam 1% materiae silicii, capacitas productionis est valde limitata.
Alti parametri producti et humilis proventus: inter parametri principales substrati SiC sunt densitas microtubulorum, densitas dislocationum, resistentia, deformatio, asperitas superficiei, et cetera. Complexa est machinatio systematis ad atomos in camera clausa altae temperaturae disponendos et incrementum crystalli perficiendum, indices parametrorum moderandos.
Materia magnam duritiam, magnam fragilitatem, longum tempus sectionis et magnam detritionem habet: duritia SiC Mohs 9.25 secunda tantum adamantibus est, quod ad significanter augendam difficultatem sectionis, terendi et poliendi ducit, et circiter 120 horas requiruntur ad 35-40 partes massae 3cm crassae secandas. Praeterea, propter magnam fragilitatem SiC, maior erit detritio in processu laminarum, et proportio productionis tantum circiter 60% est.
Progressus progressus: Incrementum magnitudinis + diminutio pretii
Linea productionis voluminis sex unciarum in foro globali SiC maturescit, et societates praecipuae mercatum octo unciarum iam intraverunt. Proposita progressionis domesticae plerumque sex uncias agunt. Quamquam nunc pleraeque societates domesticae adhuc in lineis productionis quattuor unciarum nituntur, industria paulatim ad sex uncias extenditur. Cum technologia instrumentorum sex unciarum adsit, technologia substrati SiC domestica etiam paulatim melior fit, et oeconomiae scalae linearum productionis magnae magnitudinis apparebunt, et intervallum temporis productionis massae sex unciarum domesticae ad septem annos redactum est. Magnitudo maior lamellae augmentum numeri singularum lamellarum, meliorationem proventus, et reductionem proportionis lamellarum marginalium afferre potest, et sumptus investigationis et progressionis necnon iactura proventus ad circiter septem centesimas servabuntur, ita usum lamellae emendans.
Multae adhuc difficultates in designando instrumento manent
Commercializatio diodarum SiC paulatim melior fit; nunc, nonnulli fabri domestici producta SiC SBD designaverunt, quae producta SiC SBD mediae et altae tensionis bonam stabilitatem habent. In OBC vehiculorum, SiC SBD + SI IGBT adhibentur ad densitatem currentis stabilem consequendam. Nunc, nullae sunt impedimenta in designatione patenti productorum SiC SBD in Sinis, et discrimen cum terris externis parvum est.
Multas adhuc difficultates in SiC MOS experiuntur, adhuc discrimen inter SiC MOS et fabricatores transmarinos manet, et suggestus fabricationis conexus adhuc in constructione est. In praesenti, ST, Infineon, Rohm, aliique SiC MOS 600-1700V productionem magnam consecuti sunt et multis industriis fabricatoriis subscripserunt et cum eis miserunt, dum hodierna domestica SiC MOS designatio plerumque perfecta est, nonnulli fabricatores designationis cum fabricatis in stadio fluxus laminarum laborant, et postea verificatio emptorum adhuc tempus requirit, ergo adhuc longum tempus ab commercializatione magnae scalae restat.
In praesenti, structura plana est electio vulgaris, et genus fossae late in futuro in agro altae pressionis adhibebitur. Multi sunt fabricatores structurae planae SiC MOS; structura plana non facile problemata localia interruptionis producit, si cum sulco comparetur, quod stabilitatem operis afficit. In foro infra 1200V latam applicationis varietatem habet. Structura plana relative simplex est in fine fabricationis, ut et fabricationis facultatem et sumptus moderandi satisfaciat. Instrumentum sulci commoda habet inductantiae parasiticae infimae, celeritatis commutationis magnae, iacturae humilis, et efficaciae relative altae.
2 -- Nuntii de crustulis SiC
Incrementum productionis et venditionum mercatus carburi silicii, attende ad inaequalitatem structuralem inter copiam et demandam


Cum celeriter augeatur mercatus postulationis electronicorum potentiae altae frequentiae et magnae potentiae, angustiae physicae limitationis instrumentorum semiconductorum silicio fundatorum paulatim eminere coeperunt, et materiae semiconductorum tertiae generationis, quas carburum silicii (SiC) repraesentat, paulatim ad usum industrialem pervenerunt. Ex prospectu functionis materiae, carburum silicii triplo maiorem latitudinem hiatus zonae electricae materiae silicii, decies maiorem vim campi electrici critici disruptionis, et triplo maiorem conductivitatem thermalem habet; itaque instrumenta potentiae carburi silicii apta sunt ad altam frequentiam, altam pressionem, altam temperaturam, aliasque applicationes, adiuvant ad efficientiam et densitatem potentiae systematum electronicorum potentiae augendam.
In praesenti, diodae SiC et MOSFET SiC paulatim in forum venerunt, et producta magis maturiora exstant, inter quae diodae SiC late in quibusdam campis loco diodorum silicii fundatorum adhibentur, quia commodum recuperationis inversae oneris non habent; SiC MOSFET etiam paulatim in autocinetis, accumulatione energiae, acervis onerandi, photovoltaicis aliisque campis adhibetur; in campo applicationum autocineticarum, inclinatio ad modularizationem magis magisque eminet, superior efficacia SiC processibus involucri provectis niti debet ad assequendum, cum obturatio testae relative maturior technice ut cursus principalis, futurum vel ad evolutionem obturationis plasticae, eius proprietates evolutionis personalizatae magis aptae sunt modulis SiC.
Celeritas pretii carburi silicii declinationis vel ultra imaginationem

Usus instrumentorum carburi silicii praecipue sumptu alto limitatur; pretium SiC MOSFET infra eundem gradum quater maius est quam pretium IGBT Si fundati. Hoc fit quia processus carburi silicii complexus est, in quo incrementum crystalli singularis et epitaxialis non solum in ambitum asperum est, sed etiam celeritas incrementi tarda est, et processus crystalli singularis in substratum per processum sectionis et politurae transire debet. Propter proprias proprietates materiae et technologiam processus immaturam, proventus substrati domestici minus quam 50% est, et variae causae ad pretia substrati et epitaxialis alta ducunt.
Attamen, compositio sumptuum instrumentorum carburi silicii et instrumentorum silicio fundatorum diametraliter opposita est; sumptus substrati et epitaxialis canalis anterioris 47% et 23% totius instrumenti respective constituunt, circiter 70% in summa; designatio, fabricatio et nexus obsignationis canalis posterioris tantum 30% constituunt; sumptus productionis instrumentorum silicio fundatorum praecipue in fabricatione lamellarum canalis posterioris circiter 50% concentrantur, et sumptus substrati tantum 7% efficiunt. Phaenomenon valoris catenae industriae carburi silicii inversi significat artifices epitaxiae substrati antecedentes ius loquendi fundamentale habere, quod est clavis ad ordinationem societatum domesticarum et externarum.
Ex prospectu dynamico mercatus, sumptus carburi silicii minuere, praeter meliorationem crystalli longi carburi silicii et processus sectionis, magnitudinem lamellae augere significat, quod etiam via matura progressionis semiconductorum in praeterito constituit. Data Wolfspeed ostendunt, substrato carburi silicii a 6 unciis ad 8 uncias amplificato, productionem lamellarum qualificatam 80%-90% augeri posse, et reditum emendare. Pretium unitatis coniunctum 50% reducere potest.
Annus 2023 "primus annus SiC octo unciarum" appellatur. Hoc anno, fabri domesticae et externae carburi silicii ordinationem carburi silicii octo unciarum accelerant, ut Wolfspeed, ut videtur, 14.55 miliarda dollariorum Americanorum ad productionem carburi silicii expansam collocavit, cuius pars magna est constructio officinae fabricationis substrati SiC octo unciarum. Ut futura copia metalli nudi SiC 200 mm multis societatibus praestetur, societates domesticae Tianyue Advanced et Tianke Heda etiam pacta diuturna cum Infineon signaverunt ad substrata carburi silicii octo unciarum in futuro supplenda.
Ab hoc anno, carburum silicii a sex unciis ad octo uncias accelerabit. Wolfspeed expectat ut, ante annum 2024, pretium unitatis microplagulae substrati octo unciarum, comparatum cum pretio unitatis microplagulae substrati sex unciarum anno 2022, plus quam sexaginta centesimis reducatur, et haec diminutio mercatum applicationum ulterius aperiat, secundum notitias investigationis Ji Bond Consulting. Pars mercatus hodierna productorum octo unciarum minus quam duo centesimae est, et ad circiter quindecim centesimas anno 2026 crescere exspectatur.
Re vera, pretii substrati carburi silicii diminutio multorum fortasse superat. Mercatus hodiernus substrati sex unciarum offert 4000-5000 yuan/unitate, quod, comparatione facta cum initio anni, multum cecidit, et expectatur ut infra 4000 yuan anno proximo cadat. Notandum est nonnullos artifices, ut primum mercatum adipiscantur, pretium venditionis ad lineam pretii inferiorem redegisse. Bellum pretiorum inceptum est, praesertim in substratis carburi silicii copia satis sufficiens in campo tensionis humilis. Artifices domestici et externi capacitatem productionis vehementer amplificant, vel substratum carburi silicii superfluum citius quam imaginatum est.
Tempus publicationis: XIX Ianuarii MMXXIV
